原子层沉积(Atomic layer deposition)是一种可以将物质以单原子膜形式一层一层的镀在基底表面的方法。原子层沉积与普通的化学沉积有相似之处。
但在原子层沉积过程中,新一层原子膜的化学反应是直接与之前一层相关联的,这种方式使每次反应只沉积一层原子。
单原子层沉积(atomic layer deposition,ALD),又称原子层沉积或原子层外延(atomic layer epitaxy) ,最初是由芬兰科学家提出并用于多晶荧光材料ZnS:Mn以及非晶Al2O3绝缘膜的研制,这些材料是用于平板显示器。由于这一工艺涉及复杂的表面化学过程和低的沉积速度,直至上世纪80年代中后期该技术并没有取得实质性的突破。但是到了20世纪90年代中期,人们对这一技术的兴趣在不断加强,这主要是由于微电子和深亚微米芯片技术的发展要求器件和材料的尺寸不断降低,而器件中的高宽比不断增加,这样所使用材料的厚度降低值几个纳米数量级。因此原子层沉积技术的优势就体现出来,如单原子层逐次沉积,沉积层极均匀的厚度和优异的一致性等就体现出来,而沉积速度慢的问题就不重要了。以下主要讨论原子层沉积原理和化学,原子层沉积与其他相关技术的比较,原子层沉积设备,原子层沉积的应用和原子层沉积技术的发展。
原子层沉积是通过将气相前驱体脉冲交替地通入反应器并在沉积基体上化学吸附并反应而形成沉积膜的一种方法(技术)。当前驱体达到沉积基体表面,它们会在其表面化学吸附并发生表面反应。在前驱体脉冲之间需要用惰性气体对原子层沉积反应器进行清洗。由此可知沉积反应前驱体物质能否在被沉积材料表面化学吸附是实现原子层沉积的关键。气相物质在基体材料的表面吸附特征可以看出,任何气相物质在材料表面都可以进行物理吸附,但是要实现在材料表面的化学吸附必须具有一定的活化能,因此能否实现原子层沉积,选择合适的反应前驱体物质是很重要的。
原子层沉积的表面反应具有自限制性(self-limiting),实际上这种自限制性特征正是原子层沉积技术的基础。不断重复这种自限制反应就形成所需要的薄膜。
原子层沉积的自限制特征 :根据沉积前驱体和基体材料的不同,原子层沉积有两种不同的自限制机制,即化学吸附自限制(CS)和顺次反应自限制(RS)过程。
化学吸附自限制沉积过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附(饱和吸附)保持在表面。当第二种前驱体通入反应器,起就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间会发生置换反应并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止并形成需要的原子层。因此这是一种自限制过程,而且不断重复这种反应形成薄膜。
与化学吸附自限制过程不同,顺次反应自限制原子层沉积过程是通过活性前驱体物质与活性基体材料表面化学反应来驱动的。这样得到的沉积薄膜是由于前驱体与基体材料间的化学反应形成的。下图a和b分别给出了这两种自限制反应过程的示意图。
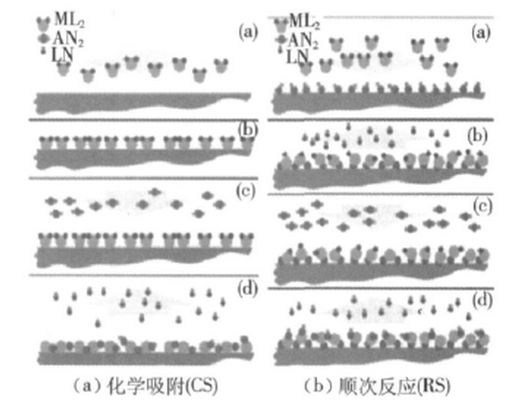
ML2 + AN2 --- MA(film) + 2LN ⑴
AN + ML2 --- AML + NL ⑵
AML + AN2 --- MAN + NL ⑶
由图可知,化学吸附自限制过程的是由吸附前驱体1(ML2)与前驱体2(AN2)直接反应生成MA原子层(薄膜构成),主要反应可以以方程式⑴表示。对于顺次反应自限制过程首先是活化剂(AN)活化基体材料表面;然后注入的前驱体1(ML2)在活化的基体材料表面反应形成吸附中间体(AML),这可以用反应方程式⑵表示。反应⑵随着活化剂AN的反应消耗而自动终止,具有自限制性。当沉积反应前驱体2(AN2)注入反应器后,就会与上述的吸附中间体反应并生成沉积原子层。
这里需要说明的是前驱体1能够在基体材料表面快速形成稳定的化学吸附层是化学吸附自限制原子沉积过程的必要条件。对于顺次反应自限制过程,一方面基体材料表面必须先经过表面活化,另一方面,这种沉积反应实际是半反应⑵和⑶的组合。每个半反应完成后材料表面的功能基团都会发生变化,并且一个原子层沉积完成时,材料表面要恢复到最初的活化基团状态。这种恢复特点以及材料表面原始活性状态是区分上述两种不同的自限制反应沉积过程的主要因素。
原子层沉积技术在沉积反应原理、沉积反应条件的要求和沉积层的质量上都与传统的PVD和CVD不同,下表比较了它们之间的主要异同点。可以看出,对于超薄膜材料而言,原子层沉积除了其沉积速率较慢外,其他优点是传统的PVD和CVD技术所无可比拟的。对于不断缩微化的硅集成电路材料,其使用材料的几何厚度已低达1nm,这时沉积速率慢的缺点就不再是主要矛盾,而精确的薄膜厚度和成分控制、优秀的表面覆盖率和沉积均匀性更重要。
| (原子层沉积)ALD | (物理气相沉积)PVD | (化学气相沉积)CVD | |
| 沉积原理 | 表面反应-沉积 | 蒸发-凝固 | 气相反应-沉积 |
| 沉积过程 | 层状生长 | 形核长大 | 形核长大 |
| 台阶覆盖率 | 优秀 | 一般 | 好 |
| 沉积速率 | 慢 | 快 | 快 |
| 沉积温度 | 低 | 低 | 高 |
| 沉积层均匀性 | 优秀 | 一般 | 较好 |
| 厚度控制 | 反应循环次数 | 沉积时间 | 沉积时间,气相分压 |
成分 | 均匀,杂质少 | 无杂质 | 易含杂质,夹杂 |
 m.cnreagent.com
m.cnreagent.com